Bump 高度快速整面量測
使用共軛焦線掃描探頭

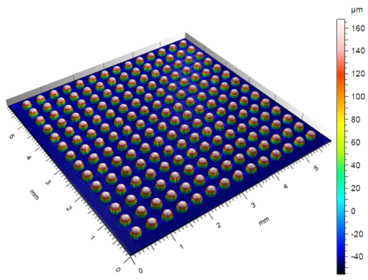
Bump 量測與截面高度

Bump 量測與截面高度
應用範圍
Bumping 是覆晶技術(Flip Chip)的一環,將 IC 腳墊覆上凸塊(bump)並與基板(Substrate)直接連接,達到提高晶片腳位的密度、增強電性效能與散熱能力、減少雜訊及縮小封裝體積等效果。其中 bump 的大小、高度、截面等會影響機械與電性特性,因此必須被管制,但使用傳統的 2.5D 影像量測不足以量測微米等級的高度,使用干涉物鏡的白光干涉可量測,但視野小於 1x1mm,對大量檢測不友善。
優點
使用彩色共軛焦顯微鏡是量測精密高度的好方法之一,以共軛焦線掃描的方式,融合了共軛焦顯微鏡的精度與雷射掃描的速度,使得如 5x10mm 的範圍,搭配不同解析度的線掃描頭,可在數秒到數十秒不等的時間,完成微米級至奈米級的輪廓掃描。
服務據點
台北總公司
105台北市松山區南京東路三段272號8樓
Tel:(02) 2740-3366
Fax:(02) 2773-5577
新竹分公司
300新竹市東區關新路27號15樓之2
Tel:(03) 564-1360
Fax:(03) 564-1363
台中分公司
406台中市北屯區文心路四段450號
Tel:(04) 2230-0077
Fax:(04) 2230-0055
台南分公司
741台南市善化區蓮潭南街33號
Tel:(06) 589-1721
Fax:(06) 589-1728
高雄分公司
806高雄市前鎮區民權二路8號12樓之2
Tel:(07) 537-3990
Fax:(07) 537-3880

